Плазменное травление
Плазменное травление — это форма плазменной обработки, используемая для изготовления интегральных схем . Она включает в себя высокоскоростной поток тлеющего разряда ( плазмы ) соответствующей газовой смеси, выстреливаемый (импульсами) в образец. Источник плазмы, известный как травящийся материал, может быть либо заряженным ( ионы ), либо нейтральным ( атомы и радикалы ). Во время процесса плазма генерирует летучие продукты травления при комнатной температуре из химических реакций между элементами травящегося материала и реактивными материалами, генерируемыми плазмой. В конечном итоге атомы дробящегося элемента внедряются на поверхность мишени или чуть ниже нее, тем самым изменяя физические свойства мишени. [1]
Механизмы
Генерация плазмы
Плазма — это высокоэнергетическое состояние, в котором может происходить множество процессов. Эти процессы происходят из-за электронов и атомов. Для образования плазмы электроны должны быть ускорены для получения энергии. Высокоэнергетические электроны передают энергию атомам посредством столкновений. Из-за этих столкновений могут происходить три различных процесса: [2] [3]
В плазме присутствуют различные виды, такие как электроны, ионы, радикалы и нейтральные частицы. Эти виды постоянно взаимодействуют друг с другом. Во время плазменного травления происходят два процесса: [4]
- генерация химических видов
- взаимодействие с окружающими поверхностями
Без плазмы все эти процессы происходили бы при более высокой температуре. Существуют различные способы изменения химии плазмы и получения различных видов плазменного травления или плазменного осаждения. Один из способов формирования плазмы — использование ВЧ-возбуждения источником питания 13,56 МГц, частоты, выделенной для этого применения в диапазонах ISM .
Режим работы плазменной системы изменится, если изменится рабочее давление. Также он различен для разных конструкций реакционной камеры. В простом случае конструкция электрода симметрична, а образец размещается на заземленном электроде.
Влияние на процесс
Ключом к разработке успешных сложных процессов травления является поиск подходящей химии газового травления, которая будет образовывать летучие продукты с материалом, который должен быть протравлен, как показано в Таблице 1. [3] Для некоторых сложных материалов (таких как магнитные материалы) летучесть может быть получена только при повышении температуры пластины. Основные факторы, влияющие на плазменный процесс: [2] [3] [5]
- Источник электронов
- Давление
- Газовые виды
- Вакуум
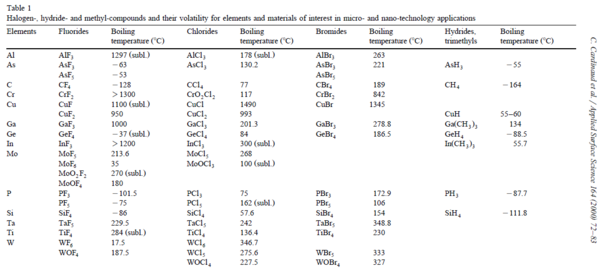
Поверхностное взаимодействие
Реакция продуктов зависит от вероятности реакции разнородных атомов, фотонов или радикалов с образованием химических соединений. Температура поверхности также влияет на реакцию продуктов. Адсорбция происходит, когда вещество способно собираться и достигать поверхности в конденсированном слое, варьирующемся по толщине (обычно это тонкий окисленный слой). Летучие продукты десорбируются в плазменной фазе и помогают процессу плазменного травления, поскольку материал взаимодействует со стенками образца. Если продукты нелетучие, на поверхности материала образуется тонкая пленка. Различные принципы, которые влияют на способность образца к плазменному травлению: [3] [6]
- Волатильность
- Адсорбция
- Химическое сродство
- Ионная бомбардировка
- Распыление
Плазменное травление может изменить углы контакта поверхности, например, гидрофильные на гидрофобные или наоборот. Сообщается, что аргоновое плазменное травление увеличивает угол контакта с 52 до 68 градусов, [7] а кислородное плазменное травление уменьшает угол контакта с 52 до 19 градусов для композитов CFRP для применения в костных пластинах. Сообщается, что плазменное травление уменьшает шероховатость поверхности с сотен нанометров до 3 нм для металлов. [8]
Типы
Давление влияет на процесс плазменного травления. Для того, чтобы произошло плазменное травление, камера должна находиться под низким давлением, менее 100 Па. Для того, чтобы создать плазму низкого давления, газ должен быть ионизирован. Ионизация происходит с помощью тлеющего заряда. Эти возбуждения происходят с помощью внешнего источника, который может выдавать до 30 кВт и частоты от 50 Гц (постоянный ток) через 5–10 Гц (импульсный постоянный ток) до радиочастот и микроволновых частот (МГц-ГГц). [2] [9]
Микроволновое плазменное травление
Микроволновое травление происходит с источниками возбуждения в диапазоне микроволн, то есть между МГц и ГГц. Один из примеров плазменного травления показан здесь. [10]

Травление водородной плазмой
Одной из форм использования газа в качестве плазменного травления является водородное плазменное травление. Поэтому можно использовать экспериментальную установку, подобную этой: [5]

Плазменный травитель
Плазменный травитель , или инструмент для травления, — это инструмент, используемый в производстве полупроводниковых приборов. Плазменный травитель производит плазму из технологического газа, обычно кислорода или фторсодержащего газа, используя высокочастотное электрическое поле , обычно 13,56 МГц . Кремниевая пластина помещается в плазменный травитель, и воздух откачивается из технологической камеры с помощью системы вакуумных насосов. Затем технологический газ вводится под низким давлением и возбуждается в плазму посредством пробоя диэлектрика .
Удержание плазмы
Промышленные плазменные травильные установки часто оснащены функцией удержания плазмы, что обеспечивает повторяемость скоростей травления и точное пространственное распределение в радиочастотах.Подсказка радиочастоты плазмы. [11] Один из методов ограничения плазмы заключается в использовании свойств оболочки Дебая , приповерхностного слоя в плазме, аналогичного двойному слою в других жидкостях. Например, если длина оболочки Дебая на щелевой кварцевой детали составляет по крайней мере половину ширины щели, оболочка закроет щель и ограничит плазму, при этом позволяя незаряженным частицам проходить через щель.
Приложения
Плазменное травление в настоящее время используется для обработки полупроводниковых материалов для их использования в производстве электроники. Небольшие элементы могут быть вытравлены на поверхности полупроводникового материала, чтобы быть более эффективным или улучшить определенные свойства при использовании в электронных устройствах. [3] Например, плазменное травление может быть использовано для создания глубоких канавок на поверхности кремния для использования в микроэлектромеханических системах . Это применение предполагает, что плазменное травление также может играть важную роль в производстве микроэлектроники. [3] Аналогичным образом в настоящее время проводятся исследования того, как этот процесс может быть адаптирован к нанометровому масштабу. [3]
В частности, травление водородной плазмой имеет другие интересные применения. При использовании в процессе травления полупроводников, травление водородной плазмой, как было показано, эффективно удаляет части собственных оксидов, обнаруженных на поверхности. [5] Травление водородной плазмой также имеет тенденцию оставлять чистую и химически сбалансированную поверхность, которая идеально подходит для ряда применений. [5]
Травление кислородной плазмой может быть использовано для анизотропного глубокого травления алмазных наноструктур путем применения высокого смещения в реакторе индуктивно-связанной плазмы/реактивного ионного травления (ICP/RIE). [12] С другой стороны, использование кислородной плазмы смещения 0 В может быть использовано для изотропного поверхностного завершения CH-терминированной алмазной поверхности. [13]
Интегральные схемы
Плазму можно использовать для выращивания пленки диоксида кремния на кремниевой пластине (с использованием кислородной плазмы) или для удаления диоксида кремния с помощью фторсодержащего газа. При использовании в сочетании с фотолитографией диоксид кремния можно выборочно наносить или удалять для трассировки путей для схем.
Для формирования интегральных схем необходимо структурировать различные слои. Это можно сделать с помощью плазменного травителя. Перед травлением на поверхность наносится фоторезист , освещается через маску и проявляется. Затем выполняется сухое травление, чтобы добиться структурированного травления. После этого процесса необходимо удалить оставшийся фоторезист. Это также делается в специальном плазменном травителе, называемом ашером. [14]
Сухое травление позволяет воспроизводимое, равномерное травление всех материалов, используемых в кремниевой и полупроводниковой технологии III-V . Используя индуктивно связанную плазму/реактивное ионное травление (ICP/RIE), даже самые твердые материалы, такие как, например, алмаз, могут быть наноструктурированы. [15] [16]
Плазменные травители также используются для удаления слоев интегральных схем при анализе неисправностей .
Печатные платы
Плазма используется для травления печатных плат, в том числе для очистки переходных отверстий. [17]
Смотрите также
Ссылки
- ^ "Plasma Etch - Plasma Etching". oxinst.com . Архивировано из оригинала 3 января 2011 г. Получено 2010-02-04 .
- ^ abc Mattox, Donald M. (1998). Справочник по обработке методом физического осаждения из паровой фазы (PVD) . Вествуд, Нью-Джерси: Noyes Publication.
- ^ abcdefg Кардино, Кристоф; Пейнон, Мари-Клод; Тессье, Пьер-Ив (2000-09-01). "Плазменное травление: принципы, механизмы, применение в микро- и нанотехнологиях". Прикладная наука о поверхности . Наука о поверхности в микро- и нанотехнологиях. 164 ( 1– 4): 72– 83. Bibcode :2000ApSS..164...72C. doi :10.1016/S0169-4332(00)00328-7.
- ^ Coburn, JW; Winters, Harold F. (1979-03-01). "Плазменное травление — обсуждение механизмов". Journal of Vacuum Science & Technology . 16 (2): 391– 403. Bibcode : 1979JVST...16..391C. doi : 10.1116/1.569958. ISSN 0022-5355.
- ^ abcd Chang, RPH; Chang, CC; Darac, S. (1982-01-01). «Плазменное травление полупроводников и их оксидов водородом». Журнал вакуумной науки и технологии . 20 (1): 45– 50. Bibcode : 1982JVST...20...45C. doi : 10.1116/1.571307 . ISSN 0022-5355.
- ^ Coburn, JW; Winters, Harold F. (1979-05-01). «Ионная и электронно-ассистированная газовая химия поверхности — важный эффект при плазменном травлении». Journal of Applied Physics . 50 (5): 3189– 3196. Bibcode : 1979JAP....50.3189C. doi : 10.1063/1.326355. ISSN 0021-8979. S2CID 98770515.
- ^ Zia, AW; Wang, Y. -Q.; Lee, S. (2015). «Влияние физического и химического плазменного травления на смачиваемость поверхности полимерных композитов, армированных углеродным волокном, для применения в костных пластинах». Advances in Polymer Technology . 34 : n/a. doi :10.1002/adv.21480.
- ^ Wasy, A.; Balakrishnan, G.; Lee, SH; Kim, JK; Kim, DG; Kim, TG; Song, JI (2014). «Обработка аргоновой плазмой металлических подложек и ее влияние на свойства покрытия из алмазоподобного углерода (DLC)». Crystal Research and Technology . 49 (1): 55– 62. Bibcode : 2014CryRT..49...55W. doi : 10.1002/crat.201300171. S2CID 98549070.
- ^ Баншах, Ройнтан Ф. (2001). Технологии осаждения пленок и покрытий . Нью-Йорк: Noyes Publication.
- ^ Кейдзо Судзуки; Садаюки Окудайра; Норриюки Сакудо; Итиро Каномата (11 ноября 1977 г.). «Микроволновое плазменное травление». Японский журнал прикладной физики . 16 (11): 1979– 1984. Bibcode :1977JaJAP..16.1979S. doi :10.1143/jjap.16.1979.
- ^ http://www.eecs.berkeley.edu/~lieber/confinedphys20Apr05.pdf [ пустой URL-адрес PDF ]
- ^ Радтке, Мариуш; Нельц, Ричард; Слаблаб, Абдаллах; Ной, Элке (2019). «Надежное нанопроизводство монокристаллических алмазных фотонных наноструктур для наномасштабного зондирования». Micromachines . 10 (11): 718. arXiv : 1909.12011 . Bibcode :2019arXiv190912011R. doi : 10.3390/mi10110718 . PMC 6915366 . PMID 31653033. S2CID 202889135.
- ^ Радтке, Мариуш; Рендер, Лара; Нельц, Ричард; Ной, Элке (2019). «Плазменная обработка и фотонные наноструктуры для мелких центров азотных вакансий в алмазе». Optical Materials Express . 9 (12): 4716. arXiv : 1909.13496 . Bibcode : 2019OMExp...9.4716R. doi : 10.1364/OME.9.004716. S2CID 203593249.
- ^ "Hochtechnologie - Weltweit | PVA TePla AG" .
- ^ Радтке, Мариуш; Нельц, Ричард; Слаблаб, Абдаллах; Ной, Элке (2019-10-24). «Надежное нанопроизводство монокристаллических алмазных фотонных наноструктур для наномасштабного зондирования». Микромашины . 10 (11). MDPI AG: 718. arXiv : 1909.12011 . doi : 10.3390/mi10110718 . ISSN 2072-666X. PMC 6915366. PMID 31653033 .
- ^ Радтке, Мариуш; Рендер, Лара; Нельц, Ричард; Ной, Элке (2019-11-21). "Плазменная обработка и фотонные наноструктуры для мелких центров азотных вакансий в алмазе". Optical Materials Express . 9 (12). The Optical Society: 4716. arXiv : 1909.13496 . Bibcode : 2019OMExp...9.4716R. doi : 10.1364/ome.9.004716 . ISSN 2159-3930.
- ^ Ли, Ынг Суок; Пак, Хэ II; Байк, Хонг Ку; Ли, Се-Джонг; Сонг, Ки Мун; Хванг, Мён Гын; Ху, Чанг Су (2003). «Воздушно-сетчатая плазма для процесса удаления пятен с печатных плат». Технология поверхностей и покрытий . 171 ( 1–3 ): 328–332 . doi :10.1016/S0257-8972(03)00295-0.
Внешние ссылки
- http://stage.iupac.org/publications/pac/pdf/1990/pdf/6209x1699.pdf [ постоянная мертвая ссылка ]